Исследование характеристик и параметров полупроводниковых диодов
Исследование характеристик и параметров полупроводниковых диодов
Ознакомиться с основными фотометрическими величинами; ознакомиться с принципом работы фотометра; проверить выполнение закона Ламберта для источника света
Общие сведения
Полупроводниковые диоды и стабилитроны
Выпрямительные диоды и стабилитроны представляют собой полупроводниковые приборы с одним электронно-дырочным переходом (p–n-переходом).
Одним из свойств p–n-перехода является способность изменять свое сопротивление в зависимости от полярности напряжения внешнего источника. Причем разница сопротивлений при прямом и обратном направлениях тока через p–n-переход может быть настолько велика, что в ряде случаев, например для силовых диодов, можно считать, что ток протекает через диод только в одном направлении – прямом, а в обратном направлении ток настолько мал, что им можно пренебречь. Прямое направление – это когда электрическое поле внешнего источника направлено навстречу электрическому полю p–n- перехода, а обратное – когда направления этих электрических полей совпадают. Полупроводниковые диоды, использующие вентильное свойство p–n-перехода, называются выпрямительными диодами и широко используются в различных устройствах для выпрямления переменного тока.
Вольт-амперная характеристика (ВАХ) идеализированного p–n-перехода описывается известным уравнением
где \(I_0\) – обратный ток p–n-перехода; \(q\) – заряд электрона \(q=1,6\cdot 10^<-19>\ Кл\); \(k\) – постоянная Больцмана \(k = 1,38⋅10^ <-23>Дж\cdot град\); \(T\) – температура в градусах Кельвина.
Графическое изображение этой зависимости представлено на рис. 1.1.
Вольт-амперная характеристика имеет явно выраженную нелинейность, что предопределяет зависимость сопротивления диода от положения рабочей точки.
Различают сопротивление статическое \(R_<ст>\) и динамическое \(R_<дин>\). Статическое сопротивление \(R_<ст>\), например в точке А (рис. 1.1), определяется как отношение напряжения \(U_A\) и тока \(I_A\), соответствующих этой точке: \(R_ <ст>= \frac
Динамическое сопротивление определяется как отношение приращений напряжения и тока (рис. 1.1): \(R_ <дин>= \frac<\Delta U><\Delta I>\);
При малых значениях отклонений \(∆U\) и \(ΔI\) можно пренебречь нелинейностью участка АВ характеристики и считать его гипотенузой прямоугольного треугольника АВС, тогда \(R_ <дин>= tgβ\).
Если продолжить линейный участок прямой ветви вольт-амперной характеристики до пересечения с осью абсцисс, то получим точку \(U_0\) – напряжение отсечки, которое отделяет начальный пологий участок характеристики, где динамическое сопротивление \(R_<дин>\) сравнительно велико от круто изменяющегося участка, где \(R_<дин>\) мало.
При протекании через диод прямого тока полупроводниковая структура нагревается, и если температура превысит при этом предельно допустимое значение, то произойдет разрушение кристаллической решетки полупроводника и диод выйдет из строя. Поэтому величина прямого тока диода ограничивается предельно допустимым значением \(I_<пр.max>\) при заданных условиях охлаждения.
Если увеличивать напряжение, приложенное в обратном направлении к диоду, то сначала обратный ток будет изменяться незначительно, а затем при определенной величине \(U_<проб>\) начнется его быстрое увеличение (рис. 1.2), что говорит о наступлении пробоя p–n-перехода. Существуют несколько видов пробоя p–n-перехода в зависимости от концентрации примесей в полупроводнике, от ширины p–n-перехода и температуры:
Необратимый пробой для полупроводникового прибора является нерабочим и недопустимым режимом.
Поэтому в паспортных данных диода всегда указывается предельно допустимое обратное напряжение \(U_<проб>\) (напряжение лавинообразования), соответствующее началу пробоя p–n-перехода. Обратное номинальное значение напряжения составляет обычно \(0,5\ U_<проб>\) и определяет класс прибора по напряжению. Так, класс 1 соответствует 100 В обратного напряжения, класс 2 – 200 В и т. д.
В некоторых случаях этот режим пробоя используют для получения круто нарастающего участка ВАХ, когда малому приращению напряжения \(∆U\) соответствует большое изменение тока \(ΔI\) (рис. 1.2). Диоды, работающие в таком режиме, называются стабилитронами, т. к. в рабочем диапазоне при изменении обратного тока от \(i_<обр. min>\) до \(i_<обр. max>\) напряжение на диоде остается почти неизменным, стабильным. Поэтому для стабилитронов рабочим является участок пробоя на обратной ветви ВАХ, а напряжение пробоя (напряжение стабилизации) является одним из основных параметров.
Стабилитроны находят широкое применение в качестве источников опорного напряжения, в стабилизаторах напряжения, в качестве ограничителей напряжения и др.
Эксперимент
Оборудование
Оборудование, используемое в лабораторной работе: вритуальный лабораторный стенд, блок No 1 (схемы А1–А4); комбинированный прибор «Сура», мультиметры; соединительные провода.
Порядок выполнения работы
Изучить схемы включения полупроводниковых приборов А1–А4 (рис. 1.3–1.6) для снятия вольт-амперных характеристик ВАХ диода и стабилитрона.
Ознакомиться с устройством лабораторного стенда, найти на стенде блок №1 и схемы А1–А4.
Порядок выполнения задания №1 «Исследование полупроводникового диода»
Экспериментальное получение прямой ветви ВАХ диода \(I_ <пр>= f(U_<пр>)\) с использованием схемы A1, представленной на рис. 1.3.
Экспериментальное получение обратной ветви ВАХ диода \(I_ <обр>= f(U_<обр>)\) с использованием схемы А2, представленной на рис. 1.4.
По данным табл. 1.1 и 1.2 построить ВАХ диода.
По ВАХ или таблицам определить:
Порядок выполнения задания No2 «Исследование полупроводникового стабилитрона»
Экспериментальное получение прямой ветви ВАХ стабилитрона \(I_ <пр>= f(U_<пр>)\) с использованием схемы A3, представленной на рис. 1.5.
Экспериментальное получение обратной ветви ВАХ стабилитрона \(I_ <обр>= f(U_<обр>)\) с использованием схемы А4, представленной на рис. 1.6.
По данным табл. 1.3 и 1.4 построить ВАХ стабилитрона.
Исследование характеристик и параметров полупроводниковых диодов
| Цель работы: | Изучение вольт – амперных характеристик полу- проводниковых германиевых и кремниевых диодов, их сравнение и анализ. |
ВВЕДЕНИЕ
Наиболее распространенным типом полупроводниковых приборов, получивших широкое применение в радиоэлектронике, являются полупроводниковые диоды (ПД). Это двухэлектродные приборы, работа которых основана на использовании свойств p – n перехода. ПД различного назначения используют и различные свойства p – n перехода (односторонняя проводимость, зависимость емкости перехода от напряжения на нем, нелинейность вольт – амперной характеристики (ВАХ), фоточувствительность, излучательная способность и т.д.).
Основной характеристикой ПД является вольт – амперная характеристика (ВАХ), представляющая собой зависимость тока диода от приложенного к нему напряжения при прямом и обратном смещении. Часть ВАХ, полученная при прямом смещении, называется прямой ветвью ВАХ, а при обратном – обратной.
Функциональные возможности и характеристики ПД определяются выбором типа полупроводникового материала, техно
логией изготовления прибора и рядом других факторов. ПД могут использоваться как самостоятельные элементы, изготовленные в отдельном корпусе (дискретные элементы), либо как составные части достаточно сложных функциональных устройств, выполненных на одном полупроводниковом кристалле – интегральных микросхем (интегральные элементы).
2.1 Принципы работыp – nперехода.
Работа практически всех полупроводниковых приборов основана на использовании свойств p – n перехода, который формируется на границе раздела двух полупроводников с различными типами носителей или с разной концентрацией носителей одного типа.
Напомним, что чистый полупроводник при 0 К является диэлектриком, поскольку все электроны внешних оболочек атомов заняты в формировании химических связей и свободных носителей заряда, способных проводить электрический ток, просто нет. С повышением температуры усиливаются колебания атомов в кристаллической решетке, и некоторые электроны могут получить дополнительную энергию и стать свободными. Так образуется пара собственных носителей электрон – дырка. Дырка – это вакансия в химической связи, образовавшаяся после выхода из нее электрона. В электрическом смысле она ведет себя как равный по величине электрону, но положительный заряд. С ростом температуры растет и число собственных носителей, поэтому проводимость полупроводника увеличивается. В этом главное отличие полупроводников от металлов. Полупроводник без примесей называется собственным полупроводником.
Если обеспечить надежный электрический контакт между полупроводниками p – и n – типа (например, путем контактной сварки), то из-за градиента концентрации носителей в области контакта возникает диффузионный поток дырок из p – области в n – область и встречный поток электронов из в n – области в p – область. Эти потоки, обусловленные инжекцией электронов и дырок через область контакта (металлургический переход), называют инжекционными (диффузионными). Преодолев металлургический переход, электроны и дырки попадают в области, в которых они являются неосновными носителями, и под действием сил притяжения диффундируют внутрь полупроводника, где встречаются с основными носителями и образуют нейтральную частицу – рекомбинируют. Каждый акт рекомбинации уничтожает пару носителей электрон – дырка.
После ухода дырок из p – области вблизи границы раздела остается объемный отрицательный заряд ионизированных атомов акцепторной примеси, и точно так же появляется объемный положительный заряд донорных атомов в n – области. Таким образом, формируется двойной слой электрических зарядов (аналог конденсатора), поле которого препятствует дальнейшей диффузии электронов и дырок и увеличивается вместе с ростом плотности объемных зарядов. В итоге наступает состояние равновесия, когда контактное поле достигает такой величины, при которой диффузия прекращается. Получившая в результате этого процесса структура называется p – n переходом.
Р – n переходы созданные путем механического соединения двух полупроводников с разным типом проводимости, называются резкими. Плавные p– n переходы создаются введением диффузионным методом донорной примеси с одной стороны собственного полупроводника и акцепторной примеси – с другой стороны.
Энергетические состояния электронов в кристаллах в физике твердого тела описывают на основе зонной теории, согласно которой электроны атомов, формирующих кристалл, могут занимать вполне определенные уровни на энергетической шкале (рис.1а). Внутренние электроны атомов заполняют набор очень близко расположенных энергетических уровней, образующих почти непрерывную зону энергий внутренних электронов (таких зон несколько, но на рис.1а показана только одна). Электроны внешних оболочек, формирующие химические 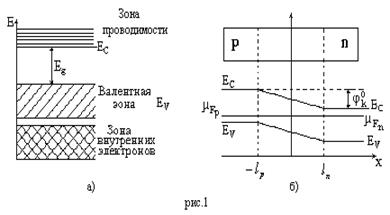
Уровень с максимальной энергией в этой зоне EV называется потолком валентной зоны. Свободные электроны могут занимать энергетические уровни в зоне проводимости, уровень с наименьшей энергией в которой, EC, называется дном зоны проводимости. Между всеми зонами разрешенных значений энергии на энергетической шкале есть некоторые интервалы, значения энергии из которых электроны иметь не могут. Это запрещенные зоны. Наибольшее влияние на свойства p – n перехода оказывает величина запрещенной зоны Eg между валентной зоной и зоной проводимости.
Процессы переноса заряда в p – n переходе принято описывать с помощью энергетических диаграмм, по оси ординат в которых откладывается энергия, а по оси абсцисс линейные размеры полупроводника в области перехода (рис.1б). Если электрон, находящийся в химической связи, получит энергию E > Eg, то он становится свободным и занимает один из свободных уровней в зоне проводимости (выше EC). Возникшая вакансия в химической связи (дырка) занимает уровень в валентной зоне (ниже EV). Если E
При внедрении в собственный полупроводник донорной или акцепторной примеси возникают дополнительные примесные уровни энергии. Избыточному валентному электрону атома – донора соответствует уровень энергии немного меньший, чем дно зоны проводимости EC. Атомы – акцепторы в полупроводнике p – типа создают примесные уровни вблизи потолка валентной зоны. Эти уровни немного выше EV, т.к. соответствуют состоянию связи, на которой не хватает одного электрона.
Энергия электронов в кристалле полностью определяется его температурой. Распределение электронов по энергиям при заданной температуре описывается вероятностно – статистическими методами. При описании физических свойств полупроводников важную роль играет уровень Ферми, т.е. уровень энергии, вероятность заполнения которого электроном при заданной температуре p=0,5. В собственном полупроводнике уровень Ферми лежит почти посредине запрещенной зоны. Появление примесных уровней приводит к смещению уровня Ферми: в донорном полупроводнике уровень Ферми смещается в сторону зоны проводимости, а в акцепторном – в сторону валентной зоны.
Для перехода электрона (дырки) с примесного уровня в зону проводимости (валентную зону) требуется небольшая дополнительная энергия. Даже при небольшом по величине и времени воздействии (тепловом, световом, электрическим напряжением и т.д.) носители становятся свободными и могут обеспечивать электропроводность. Чем ближе уровень Ферми расположен к одной из границ запрещенной зоны, тем легче носителям примесных уровней стать свободными. Таким образом, полупроводник с уровнем Ферми 

Наличие контактного поля p – n перехода приводит к изменению положения уровней EV и EС, энергетические зоны в области перехода искривляются (рис.1б). Поэтому при переходе электрона из n –области в p – область он должен преодолеть потенциальный барьер, равный 
В области пространственного заряда ( 
Приложенное внешнее напряжение U суммируется в области p – n перехода с контактной разностью потенциалов VK, определяющей высоту потенциального барьера j 0 к (рис.2). Величина jк будет изменяться в пределах 
Если поле внешнего напряжения противоположно полю контактной разности потенциалов, то барьер 

При обратной полярности приложенного напряжения потенциальный барьер 

2.2 Вольт – амперные характеристики p – n перехода
При выводе уравнения ВАХ принимают два условия:
1) p– n переход работает при низком уровне инжекции, т.е. концентрация прошедших через металлургический переход зарядов из соседней области (неосновных для данной области), мала по сравнению с концентрацией основных носителей;
2) в области p– n перехода отсутствуют генерация и рекомбинация носителей. Это соответствует условию 
Обозначим концентрации электронов и дырок в p–области, соответственно, np и pp, а вn– области nn и pn. По статистике Максвелла – Больцмана равновесная концентрация неосновных носителей (например, дырок вn– области) в отсутствии внешнего напряжения на переходе записывается:


При подаче прямого напряжения U концентрация дырок в области 

Следовательно, в области 

Отметим, что избыточная концентрация дырок 
Аналогичным путем получим избыточную концентрацию электронов в области 

Избыточные концентрации электронов и дырок создают условия для диффузии инжектированных в n– область электронов вглубь этих областей. Концентрация этих носителей будет уменьшаться при удалении от p– n перехода за счет рекомбинации с основными носителями. Для сохранения электронейтральности из глубины n– и р– областей к p– n переходу притягиваются электроны и дырки, которые и обеспечивают процессы рекомбинации инжектированных неосновных зарядов. Таким образом инжекционный ток электронов 


Плотности электронной и дырочной составляющих диффузионных токов в области p– n перехода определяются соотношениями:


где: Dp и Dn – коэффициенты диффузии электронов и дырок.
Согласно второму принятому условию в области p – n перехода концентрация инжектированных носителей не меняется поскольку там нет генерации и рекомбинации носителей. Поэтому в области 






S – площадь поперечного сечения p – n перехода.
Ток 



Величина прямого и обратного тока p – n перехода весьма сильно зависит от материала полупроводника при прочих равных условиях. Основную роль играет ширина запрещенной зоны Eg, определяющая концентрацию свободных носителей. Так при комнатной температуре T=300 К, Eg=1,12 эВ для кремния (Si) и Eg=0,66 эВ для германия (Ge). При той же температуре концентрация собственных носителей (электронов) составляет 

С увеличением концентрации примесей в прилегающих к переходу областях плотность тока насыщения должна уменьшаться.
Если p – n переход не симметричный, т.е. одна из областей содержит большую концентрацию примеси (сильнее легирована), чем другая, и поэтому имеет большую проводимость, то при прямом смещении p – n перехода преобладает поток носителей из сильно легированной области в слабо легированную и ток создается практически носителями, одного знака. Слабо легированную область диода называют базой, а сильно легированную – эмиттером.
Если, например, проводимость sn n – области много больше проводимости sp р – области, т.е. концентрация доноров Nд в n – области много больше концентрации акцепторов Na вp–области, то инжекция электронов из n- эмиттера в p- базу приводит к “заливанию” базы электронами. В этом случае (2.11) можно записать в виде:


Инжектированные электроны рекомбинируют в базе с дырками и энергия рекомбинации выделяется в виде тепла, что приведет к разогреву диода. Использование полупроводниковых материалов с большой запрещенной зоной (арсенид галлия, фосфид индия, карбид кремния) позволяет преобразовать энергию электронно-дырочной рекомбинации в кванты света. Такие диоды широко применяются в качестве различных индикаторов (светодиоды), либо источников когерентного излучения (полупроводниковые лазеры).



Рис.3 представляет типичную ВАХ p – n перехода при обратных напряжениях меньше напряжения пробоя. Область 1 соответствует прямому смещению p – n перехода, область 2 – обратному.
2.3 Пробой p – n перехода
При некотором критическом значении обратного напряжения на p – nпереходе малый обратный ток начинает резко возрастать. Это явление называют пробоем p – n перехода.
Для большинства типов диодов пробой – явление нежелательное, поскольку из-за резкого роста тока в p – n переходе выделяется большое количество тепла, что приводит к необратимым структурным изменениям. Если же мощность, выделяющаяся в p – n переходе, не превышает предельно допустимую, то p – n переход сохраняет работоспособность и после пробоя. Поэтому для некоторых типов диодов пробой является основным рабочим режимом.
Существуют три основных механизма пробоя: тепловой, лавинный и полевой (туннельный). Два последних механизма пробоя – электрические.
Резкий рост обратного тока p – n перехода возможен при увеличении числа носителей в самом p – n переходе. При тепловом пробое это происходит за счет выделения тепла на сопротивлении перехода при прохождении через него обратного тока. Напряжение пробоя, как показывают расчеты, определяется обратным током p – n перехода, температурным коэффициентом обратного тока ( 
Пробивное напряжение при тепловом пробое зависит от обратного тока через диод при заданной температуре, поэтому в диодах с большими обратными токами уже при комнатной температуре возникают условия теплового пробоя и он наступает раньше, чем другие виды пробоя. Обратный ток больше у полупроводников с узкой запрещенной зоной, поэтому для германиевых диодов условия теплового пробоя выполняются уже при сравнительно низких температурах, раньше чем наступают другие виды пробоя. Тепловой пробой в кремниевых диодах может происходить при высоких температурах. Пробой может начаться как лавинный, а по мере увеличения обратного тока перейти в тепловой.
Лавинный пробой p – n перехода – это пробой, вызванный лавинным размножением носителей заряда под действием сильного электрического поля. Неосновные носители, проходя через область p – n перехода при обратном напряжении, приобретают в сильном электрическом поле на длине свободного пробега дополнительную энергию, достаточную для образования новых электронно-дырочных пар путем ударной ионизации атомов полупроводника. Вновь образованные носители тоже попадают в сильное электрическое поле и на длине свободного пробега приобретают достаточную для ионизации следующего атома энергию. Процесс развивается лавинообразно, что и отражает название пробоя.

С повышением температуры уменьшается длинна свободного пробега носителей заряда, а значит, и энергия, которую носитель заряда может приобрести на ней в электрическом поле. Поэтому повышение температуры приводит к увеличению пробивного напряжения при лавинном пробое (рис.4, кривая 2).
Туннельный пробой p-n перехода может происходить только в полупроводниках с большой концентрацией примесей, т.к. для туннелирования нужны малая толщина потенциального барьера и, следовательно, малая толщина перехода. При этих условиях пробивные напряжения тоже невелики, обычно не более 5 В.